Gumagamit ang SMT ng conventional solder paste air reflow welding cavity analysis at solution (2023 Essence Edition), karapat-dapat ka!
1 Panimula

Sa circuit board assembly, ang solder paste ay naka-print muna sa circuit board solder pad, at pagkatapos ay ang iba't ibang mga elektronikong sangkap ay nakakabit. Sa wakas, pagkatapos ng reflow furnace, ang mga butil ng lata sa solder paste ay natunaw at ang lahat ng uri ng mga elektronikong sangkap at ang solder pad ng circuit board ay hinangin nang magkasama upang mapagtanto ang pagpupulong ng mga de-koryenteng submodules. Ang surfacemounttechnology (sMT) ay lalong ginagamit sa mga produkto ng high-density packaging, gaya ng system level package (siP), ballgridarray (BGA) device, at power bare Chip, square flat pin-less package (quad aatNo-lead, tinutukoy bilang QFN) device.
Dahil sa mga katangian ng proseso ng welding ng solder paste at mga materyales, pagkatapos ng reflow welding ng mga malalaking solder surface device na ito, magkakaroon ng mga butas sa solder welding area, na makakaapekto sa mga electrical properties, thermal properties at mekanikal na katangian ng produkto Performance, at kahit na humantong sa pagkabigo ng produkto, samakatuwid, upang mapabuti ang solder paste reflow welding cavity ay naging isang proseso at teknikal na problema na dapat malutas at pinag-aralan ng ilang mga mananaliksik ang solder ball, at sinuri namin ang solder ball. nagbigay ng mga solusyon sa pagpapahusay, ang conventional solder paste reflow welding process welding area ng QFN na mas malaki sa 10mm2 o welding area na mas malaki kaysa sa 6 mm2's bare chip solution ay kulang.
Gumamit ng Preformsolder welding at vacuum reflux furnace welding para mapabuti ang weld hole. Ang prefabricated solder ay nangangailangan ng espesyal na kagamitan upang ituro ang pagkilos ng bagay. Halimbawa, ang chip ay na-offset at seryosong tumagilid pagkatapos na mailagay ang chip nang direkta sa prefabricated na panghinang. Kung ang flux mount chip ay reflow at pagkatapos ay ituro, ang proseso ay nadagdagan ng dalawang reflow, at ang halaga ng prefabricated solder at flux material ay mas mataas kaysa sa solder paste.
Ang mga kagamitan sa vacuum reflux ay mas mahal, ang kapasidad ng vacuum ng independiyenteng silid ng vacuum ay napakababa, ang pagganap ng gastos ay hindi mataas, at ang problema sa pag-splash ng lata ay seryoso, na isang mahalagang kadahilanan sa paggamit ng mga high-density at small-pitch na mga produkto. Sa papel na ito, batay sa conventional solder paste reflow welding process, ang isang bagong pangalawang reflow welding na proseso ay binuo at ipinakilala upang mapabuti ang welding cavity at malutas ang mga problema ng bonding at plastic seal cracking na dulot ng welding cavity.
2 Solder paste printing reflow welding cavity at mekanismo ng produksyon
2.1 Welding cavity
Pagkatapos ng reflow welding, ang produkto ay nasubok sa ilalim ng x-ray. Ang mga butas sa welding zone na may mas magaan na kulay ay natagpuan na dahil sa hindi sapat na solder sa welding layer, tulad ng ipinapakita sa Figure 1
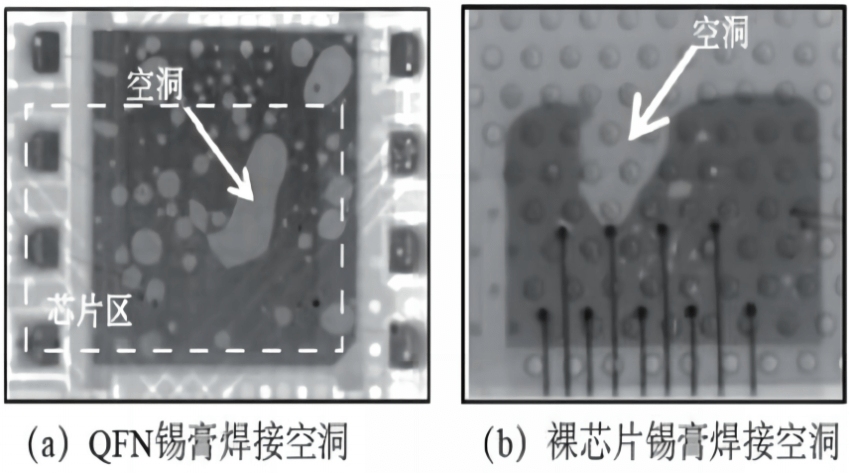
X-ray detection ng bubble hole
2.2 Mekanismo ng pagbuo ng welding cavity
Ang pagkuha ng sAC305 solder paste bilang isang halimbawa, ang pangunahing komposisyon at function ay ipinapakita sa Talahanayan 1. Ang flux at tin beads ay pinagsama sa hugis ng paste. Ang ratio ng timbang ng tin solder sa flux ay humigit-kumulang 9:1, at ang ratio ng volume ay humigit-kumulang 1:1.

Matapos mai-print at mai-mount ang solder paste na may iba't ibang mga elektronikong sangkap, ang solder paste ay sasailalim sa apat na yugto ng preheating, activation, reflux at cooling kapag dumaan ito sa reflux furnace. Iba rin ang estado ng solder paste na may iba't ibang temperatura sa iba't ibang yugto, tulad ng ipinapakita sa Figure 2.
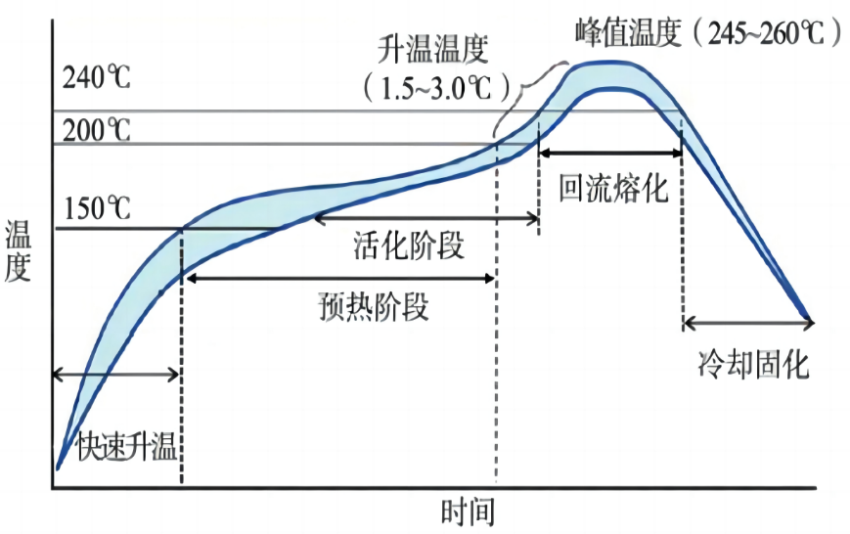
Sanggunian sa profile para sa bawat lugar ng paghihinang ng reflow
Sa yugto ng preheating at activation, ang mga pabagu-bagong bahagi sa flux sa solder paste ay magiging gas kapag pinainit. Kasabay nito, ang mga gas ay gagawin kapag ang oksido sa ibabaw ng welding layer ay tinanggal. Magiging volatilize ang ilan sa mga gas na ito at mag-iiwan ng solder paste, at ang mga solder beads ay masikip nang mahigpit dahil sa volatilization ng flux. Sa yugto ng reflux, ang natitirang flux sa solder paste ay mabilis na sumingaw, ang mga butil ng lata ay matutunaw, isang maliit na halaga ng flux na pabagu-bago ng isip na gas at ang karamihan sa hangin sa pagitan ng mga butil ng lata ay hindi magkakalat sa oras, at ang nalalabi sa tinunaw na lata at sa ilalim ng pag-igting ng tinunaw na lata ay hamburger na istraktura ng sandwich at nahuhuli ng mga likidong bahagi ng pambalot ng pambalot ng gas at mga elektronikong sangkap sa panghinang. makatakas lamang sa pamamagitan ng pataas na buoyancy Ang itaas na oras ng pagkatunaw ay napakaikli. Kapag ang tinunaw na lata ay lumamig at naging solidong lata, ang mga pores ay lilitaw sa welding layer at ang mga solder hole ay nabuo, tulad ng ipinapakita sa Figure 3.
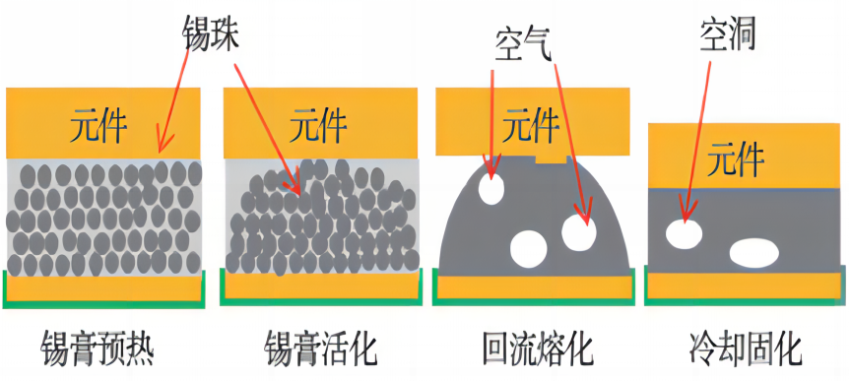
Schematic diagram ng void na nabuo ng solder paste reflow welding
Ang ugat na sanhi ng welding cavity ay ang hangin o pabagu-bago ng isip na gas na nakabalot sa solder paste pagkatapos matunaw ay hindi ganap na nadidiskarga. Ang mga salik na nakakaimpluwensya ay kinabibilangan ng solder paste na materyal, solder paste na hugis ng pag-print, solder paste na halaga ng pag-print, reflux temperature, reflux time, welding size, structure at iba pa.
3. Pag-verify ng mga nakakaimpluwensyang mga kadahilanan ng pag-print ng solder paste na mga butas ng hinang ng reflow
Ginamit ang QFN at bare chip test upang kumpirmahin ang mga pangunahing sanhi ng reflow welding voids, at para maghanap ng mga paraan upang mapabuti ang reflow welding voids na naka-print sa pamamagitan ng solder paste. Ang QFN at hubad na chip solder paste reflow welding product profile ay ipinapakita sa Figure 4, QFN welding surface size ay 4.4mmx4.1mm, welding surface ay tinned layer (100% purong lata); Ang laki ng welding ng bare chip ay 3.0mmx2.3mm, ang welding layer ay sputtered nickel-vanadium bimetallic layer, at ang surface layer ay vanadium. Ang welding pad ng substrate ay electroless nickel-palladium gold-dipping, at ang kapal ay 0.4μm/0.06μm/0.04μm. SAC305 solder paste ang ginagamit, ang solder paste printing equipment ay DEK Horizon APix, ang reflux furnace equipment ay BTUPyramax150N, at ang x-ray equipment ay DAGExD7500VR.
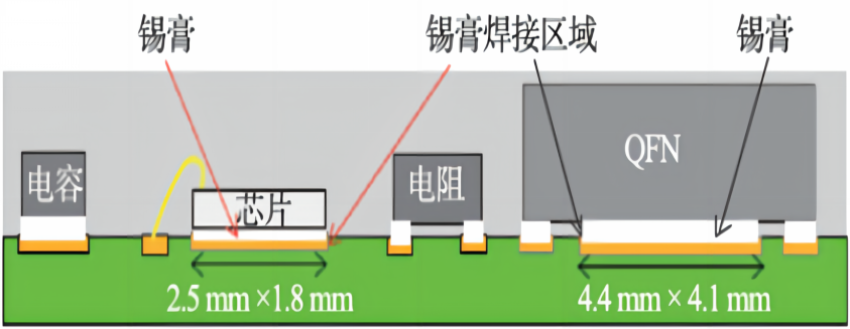
QFN at hubad na chip welding drawings
Upang mapadali ang paghahambing ng mga resulta ng pagsubok, ang reflow welding ay isinagawa sa ilalim ng mga kondisyon sa Talahanayan 2.

Reflow welding condition table
Matapos makumpleto ang surface mounting at reflow welding, ang welding layer ay nakita ng X-ray, at napag-alaman na may malalaking butas sa welding layer sa ilalim ng QFN at bare chip, tulad ng ipinapakita sa Figure 5.
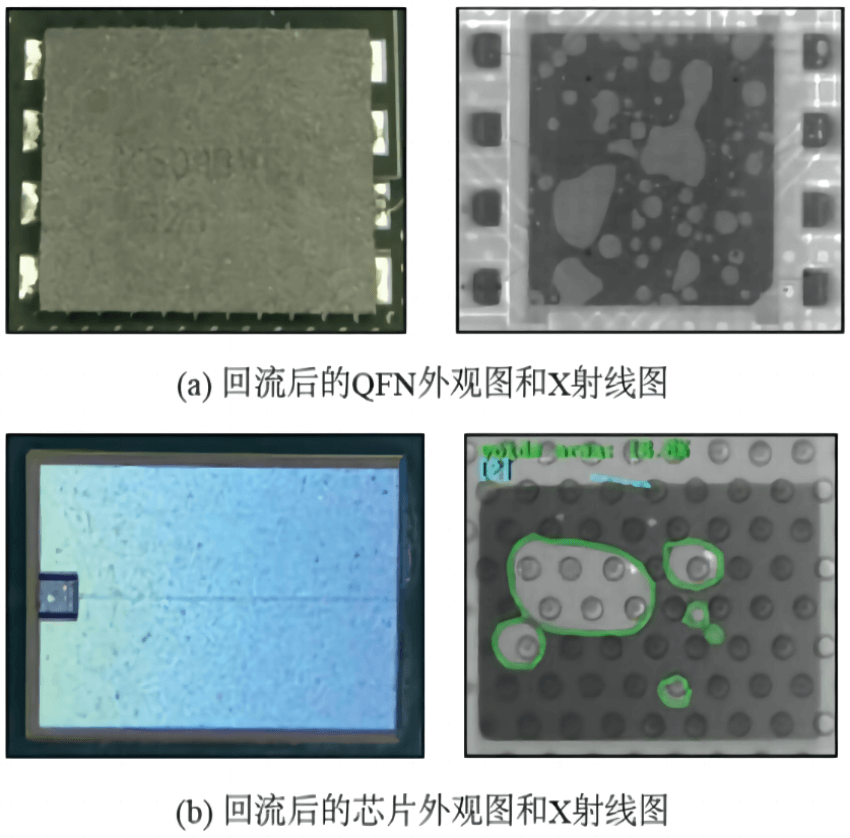
QFN at Chip Hologram (X-ray)
Dahil ang laki ng butil ng lata, kapal ng bakal na mesh, rate ng pagbubukas ng lugar, hugis ng bakal na mesh, oras ng reflux at peak furnace na temperatura ay lahat ay makakaapekto sa reflow welding voids, maraming mga salik na nakakaimpluwensya, na direktang mabe-verify ng DOE test, at ang bilang ng mga eksperimentong grupo ay magiging masyadong malaki. Kinakailangang mabilis na ma-screen at matukoy ang pangunahing mga salik na nakakaimpluwensya sa pamamagitan ng pagsubok sa paghahambing ng ugnayan, at pagkatapos ay higit pang i-optimize ang mga pangunahing salik na nakakaimpluwensya sa pamamagitan ng DOE.
3.1 Mga sukat ng mga butas ng panghinang at mga butil ng lata ng panghinang
Sa type3 (bead size 25-45 μm) SAC305 solder paste test, ang ibang mga kundisyon ay nananatiling hindi nagbabago. Pagkatapos ng reflow, ang mga butas sa solder layer ay sinusukat at inihambing sa type4 solder paste. Napag-alaman na ang mga butas sa solder layer ay hindi gaanong naiiba sa pagitan ng dalawang uri ng solder paste, na nagpapahiwatig na ang solder paste na may iba't ibang laki ng butil ay walang halatang impluwensya sa mga butas sa solder layer, na hindi isang salik na nakakaimpluwensya, tulad ng ipinapakita sa FIG. 6 Gaya ng ipinapakita.

Paghahambing ng mga butas ng metal na lata na may iba't ibang laki ng butil
3.2 Kapal ng welding cavity at printed steel mesh
Pagkatapos ng reflow, ang lugar ng lukab ng welded layer ay sinusukat gamit ang naka-print na steel mesh na may kapal na 50 μm, 100 μm at 125 μm, at ang iba pang mga kondisyon ay nanatiling hindi nagbabago. Napag-alaman na ang epekto ng iba't ibang kapal ng steel mesh (solder paste) sa QFN ay inihambing sa naka-print na steel mesh na may kapal na 75 μm Habang tumataas ang kapal ng steel mesh, unti-unting bumababa ang lugar ng lukab. Matapos maabot ang isang tiyak na kapal (100μm), ang lugar ng lukab ay babalik at magsisimulang tumaas sa pagtaas ng kapal ng bakal na mesh, tulad ng ipinapakita sa Figure 7.
Ipinapakita nito na kapag ang dami ng solder paste ay nadagdagan, ang likidong lata na may reflux ay natatakpan ng chip, at ang labasan ng natitirang air escape ay makitid lamang sa apat na gilid. Kapag binago ang dami ng solder paste, tataas din ang labasan ng natitirang air escape, at ang instant na pagsabog ng hangin na nakabalot sa likidong lata o pabagu-bago ng gas na tumatakas na likidong lata ay magiging sanhi ng pag-splash ng likidong lata sa paligid ng QFN at sa chip.
Natuklasan ng pagsubok na sa pagtaas ng kapal ng bakal na mesh, ang pagsabog ng bula na dulot ng pagtakas ng hangin o pabagu-bago ng hangin ay tataas din, at ang posibilidad ng pag-splash ng lata sa paligid ng QFN at chip ay tataas din.

Paghahambing ng mga butas sa bakal na mesh ng iba't ibang kapal
3.3 Area ratio ng welding cavity at steel mesh opening
Ang naka-print na steel mesh na may rate ng pagbubukas ng 100%, 90% at 80% ay nasubok, at ang iba pang mga kondisyon ay nanatiling hindi nagbabago. Pagkatapos ng reflow, ang lugar ng lukab ng welded layer ay sinusukat at inihambing sa naka-print na steel mesh na may 100% opening rate. Napag-alaman na walang makabuluhang pagkakaiba sa lukab ng welded layer sa ilalim ng mga kondisyon ng rate ng pagbubukas ng 100% at 90% 80%, tulad ng ipinapakita sa Figure 8.

Paghahambing ng lukab ng iba't ibang lugar ng pagbubukas ng iba't ibang steel mesh
3.4 Welded cavity at naka-print na steel mesh na hugis
Sa pagsubok ng hugis ng pag-print ng solder paste ng strip b at inclined grid c, ang ibang mga kondisyon ay nananatiling hindi nagbabago. Pagkatapos ng reflow, ang lugar ng lukab ng welding layer ay sinusukat at inihambing sa hugis ng pag-print ng grid a. Napag-alaman na walang makabuluhang pagkakaiba sa cavity ng welding layer sa ilalim ng mga kondisyon ng grid, strip at inclined grid, tulad ng ipinapakita sa Figure 9.
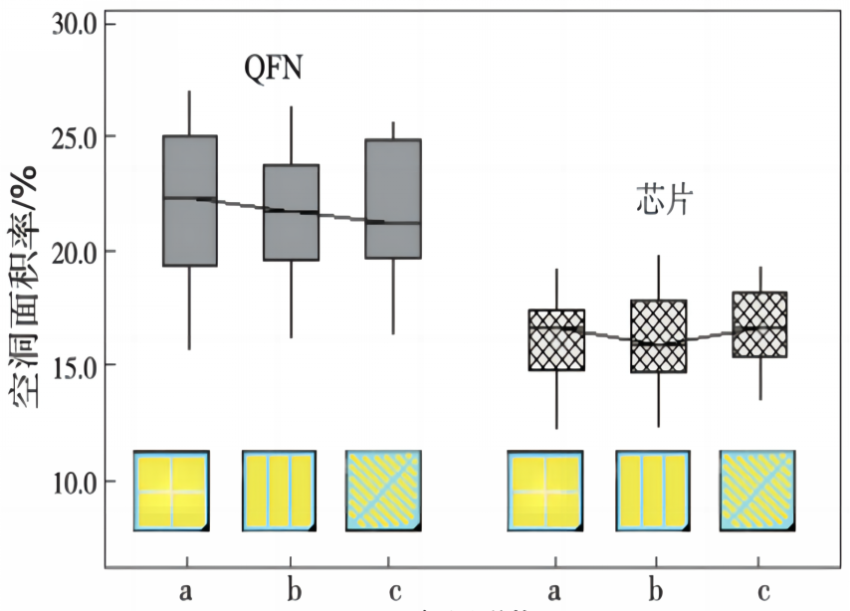
Paghahambing ng mga butas sa iba't ibang mga mode ng pagbubukas ng steel mesh
3.5 Welding cavity at reflux time
Pagkatapos ng matagal na reflux time (70 s, 80 s, 90 s) na pagsubok, ang iba pang mga kondisyon ay nananatiling hindi nagbabago, ang butas sa welding layer ay sinusukat pagkatapos ng reflux, at kumpara sa reflux time na 60 s, natagpuan na sa pagtaas ng reflux time, ang welding hole area ay nabawasan, ngunit ang pagbawas ng amplitude sa Figur ay unti-unting nabawasan. ang kaso ng hindi sapat na oras ng kati, ang pagtaas ng oras ng kati ay nakakatulong sa buong pag-apaw ng hangin na nakabalot sa tinunaw na likidong lata, ngunit pagkatapos ng oras ng kati ay tumaas sa isang tiyak na oras, ang hangin na nakabalot sa likidong lata ay mahirap umapaw muli. Ang reflux time ay isa sa mga salik na nakakaapekto sa welding cavity.

Walang bisa ang paghahambing ng iba't ibang haba ng oras ng reflux
3.6 Welding cavity at peak furnace temperature
Sa 240 ℃ at 250 ℃ peak furnace temperature test at iba pang mga kondisyon na hindi nagbabago, ang cavity area ng welded layer ay sinusukat pagkatapos ng reflow, at kung ikukumpara sa 260 ℃ peak furnace temperature, napag-alaman na sa ilalim ng iba't ibang peak furnace na kondisyon ng temperatura, ang cavity ng welded layer ng QFN at chip ay hindi nagpapakita ng kakaibang pagbabago sa QFN at chip1. Ang temperatura ng pugon ay walang malinaw na epekto sa QFN at ang butas sa welding layer ng chip, na hindi isang salik na nakakaimpluwensya.

Walang bisa ang paghahambing ng iba't ibang peak temperature
Ang mga pagsusuri sa itaas ay nagpapahiwatig na ang mga makabuluhang salik na nakakaapekto sa weld layer na lukab ng QFN at chip ay reflux time at steel mesh thickness.
4 Solder paste printing reflow welding cavity improvement
4.1DOE test para mapabuti ang welding cavity
Ang butas sa welding layer ng QFN at chip ay napabuti sa pamamagitan ng paghahanap ng pinakamainam na halaga ng pangunahing mga kadahilanan na nakakaimpluwensya (oras ng reflux at kapal ng bakal na mesh). Ang solder paste ay SAC305 type4, ang steel mesh na hugis ay grid type (100% opening degree), ang peak furnace temperature ay 260 ℃, at iba pang mga kondisyon ng pagsubok ay pareho sa mga test equipment. Ang pagsubok at resulta ng DOE ay ipinakita sa Talahanayan 3. Ang mga impluwensya ng steel mesh thickness at reflux time sa QFN at chip welding hole ay ipinapakita sa Figure 12. Sa pamamagitan ng interaksyon na pagsusuri ng mga pangunahing salik na nakakaimpluwensya, Napag-alaman na ang paggamit ng 100 μm steel mesh na kapal at 80 s reflux time ay maaaring makabuluhang bawasan ang welding cavity ng QFN at chip. Ang welding cavity rate ng QFN ay nabawasan mula sa maximum na 27.8% hanggang 16.1%, at ang welding cavity rate ng chip ay nabawasan mula sa maximum na 20.5% hanggang 14.5%.
Sa pagsubok, 1000 produkto ang ginawa sa ilalim ng pinakamainam na kondisyon (100 μm steel mesh kapal, 80 s reflux time), at ang welding cavity rate na 100 QFN at chip ay random na sinusukat. Ang average na welding cavity rate ng QFN ay 16.4%, at ang average na welding cavity rate ng chip ay 14.7% Ang weld cavity rate ng chip at ang chip ay malinaw na nabawasan.

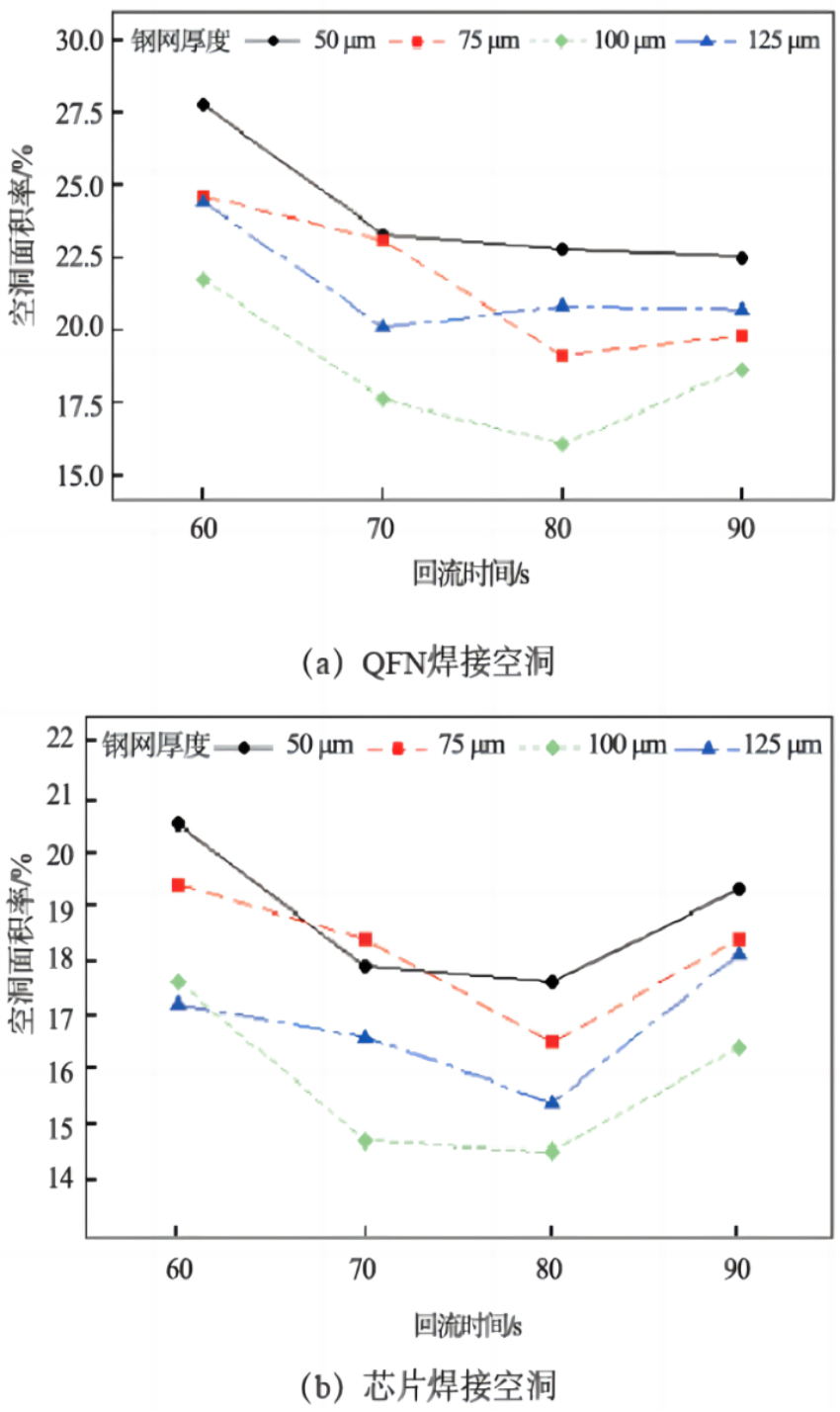
4.2 Ang bagong proseso ay nagpapabuti sa welding cavity
Ang aktwal na sitwasyon ng produksyon at pagsubok ay nagpapakita na kapag ang welding cavity area sa ilalim ng chip ay mas mababa sa 10%, ang chip cavity position cracking problem ay hindi mangyayari sa panahon ng lead bonding at molding. Ang mga parameter ng proseso na na-optimize ng DOE ay hindi maaaring matugunan ang mga kinakailangan ng pagsusuri at paglutas ng mga butas sa maginoo na solder paste reflow welding, at ang welding cavity area rate ng chip ay kailangang bawasan pa.
Dahil pinipigilan ng chip na natatakpan sa solder ang gas sa solder mula sa pagtakas, ang butas sa ilalim ng chip ay higit na nababawasan sa pamamagitan ng pag-aalis o pagbabawas ng solder coated gas. Isang bagong proseso ng reflow welding na may dalawang solder paste printing ay pinagtibay: isang solder paste printing, isang reflow na hindi sumasaklaw sa QFN at bare chip na naglalabas ng gas sa solder; Ang partikular na proseso ng pag-print ng pangalawang solder paste, patch at pangalawang reflux ay ipinapakita sa Figure 13.
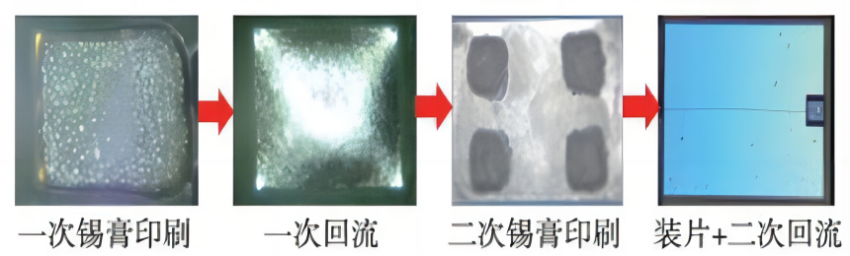
Kapag ang 75μm na makapal na solder paste ay naka-print sa unang pagkakataon, karamihan sa gas sa solder na walang chip cover ay lumalabas sa ibabaw, at ang kapal pagkatapos ng reflux ay humigit-kumulang 50μm. Matapos makumpleto ang pangunahing reflux, ang mga maliliit na parisukat ay naka-print sa ibabaw ng pinalamig na solidified solder (upang mabawasan ang dami ng solder paste, bawasan ang dami ng gas spillover, bawasan o alisin ang solder spatter), at ang solder paste na may kapal na 50 μm (ang mga resulta ng pagsubok sa itaas ay nagpapakita na ang 100 μm ay ang pinakamahusay, kaya ang kapal ng pag-print ay 50μm. μm), pagkatapos ay i-install ang chip, at pagkatapos ay bumalik sa 80 s. Halos walang butas sa panghinang pagkatapos ng unang pag-print at reflow, at ang solder paste sa pangalawang pag-print ay maliit, at ang welding hole ay maliit, tulad ng ipinapakita sa Figure 14.
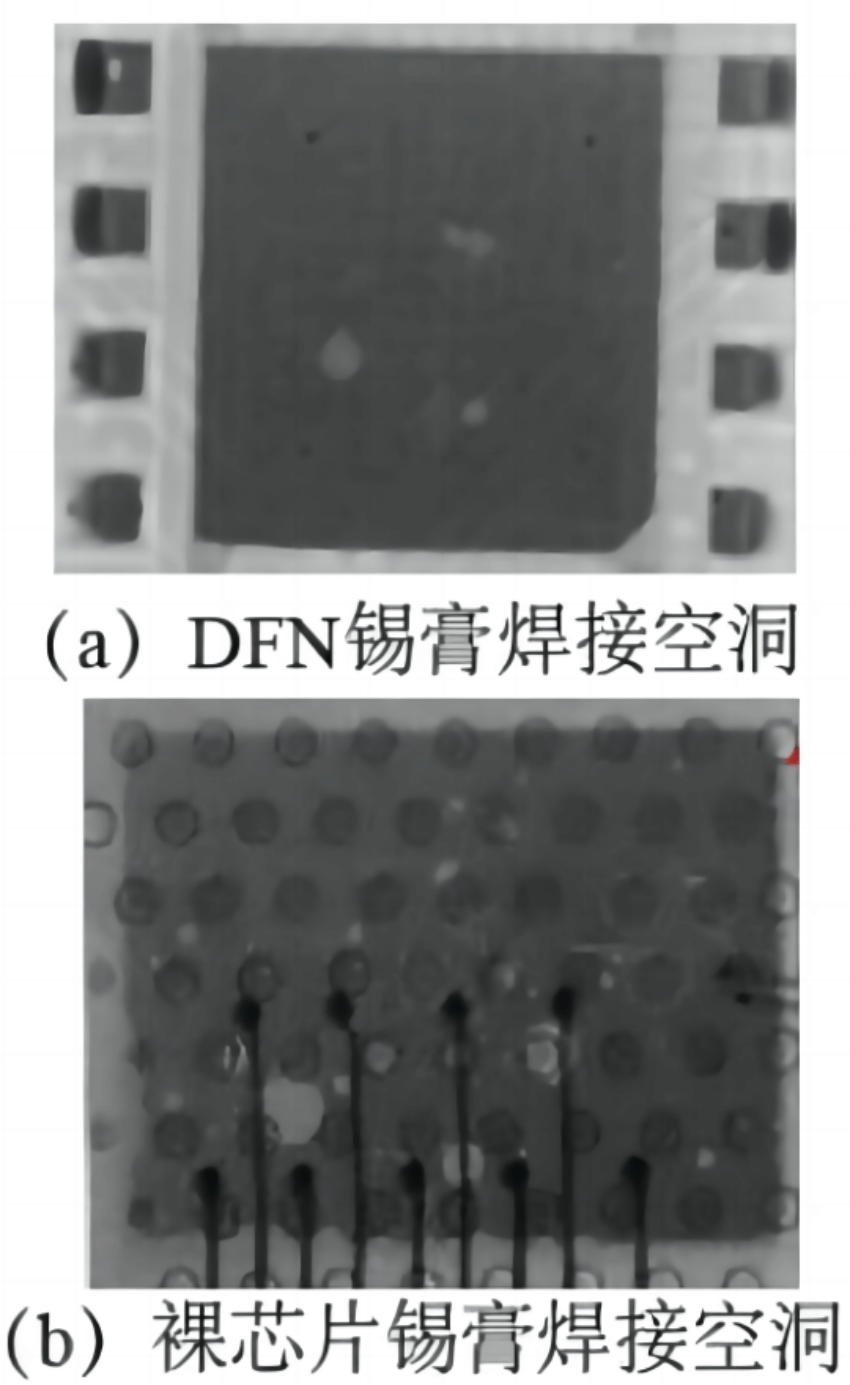
Pagkatapos ng dalawang pag-print ng solder paste, guwang na pagguhit
4.3 Pagpapatunay ng epekto ng welding cavity
Produksyon ng 2000 na mga produkto (ang kapal ng unang pagpi-print ng steel mesh ay 75 μm, ang kapal ng pangalawang pagpi-print ng steel mesh ay 50 μm), iba pang mga kondisyon na hindi nagbabago, random na pagsukat ng 500 QFN at chip welding cavity rate, natagpuan na ang bagong proseso pagkatapos ng unang reflux walang cavity, pagkatapos ng ikalawang welding rate ay QFN ang maximum na reflux cavity, at ang pinakamataas na rate ng welding QFN. cavity rate ng chip ay 4.1%. Kung ikukumpara sa orihinal na proseso ng pag-welding ng single-paste na pag-print at sa prosesong na-optimize ng DOE, ang welding cavity ay makabuluhang nabawasan, tulad ng ipinapakita sa Figure 15. Walang nakitang mga crack crack pagkatapos ng functional na mga pagsubok sa lahat ng mga produkto.

5 Buod
Ang pag-optimize ng halaga ng pag-print ng solder paste at oras ng reflux ay maaaring mabawasan ang lugar ng welding cavity, ngunit ang welding cavity rate ay malaki pa rin. Ang paggamit ng dalawang solder paste printing reflow welding techniques ay maaaring epektibo at ma-maximize ang welding cavity rate. Ang welding area ng QFN circuit bare chip ay maaaring 4.4mm x4.1mm at 3.0mm x2.3mm ayon sa pagkakabanggit sa mass production Ang cavity rate ng reflow welding ay kinokontrol sa ibaba 5%, na nagpapabuti sa kalidad at pagiging maaasahan ng reflow welding. Ang pananaliksik sa papel na ito ay nagbibigay ng isang mahalagang sanggunian para sa pagpapabuti ng welding cavity problema ng malaking lugar welding surface.






